液冷新篇!热数科技微通道技术领跑AI算力时代
高功耗浪潮下,微通道技术成刚需
微通道水冷板(MLCP)通过流道从“毫米级”到“微米级”的跃阶,突破“金属盖-液冷板”传统分体桎梏,采用微米级一体化集成工艺,在基板内嵌入数百条50-150μm级微流道,热阻链路被压缩到极致,换热效率是普通冷板的5倍以上,能应对高达800W/cm²的热流密度,契合AI计算对“高效散热+紧凑空间”的双重需求。
前瞻性布局,热数科技构建微通道技术领先优势
依托在热管理领域的深厚学术造诣与丰富的行业实践经验,热数科技精准预判散热技术升级趋势,通过组建“产学研”专班,围绕微通道结构设计、材料适配与工艺优化三大核心环节展开攻关,历经无数次试验与迭代,成功构建起覆盖“设计-仿真-试制-验证”的全链条技术体系。目前,公司微通道水冷板产品已向国内多所顶尖高校、研究所完成送样与测试,其核心性能指标全面优于行业基准,在散热效率、稳定性、空间适配性等关键维度展现出强劲竞争力,充分印证了热数科技前瞻性研发战略的正确性与技术实力。
芯片衬底刻蚀技术:精准控温的“微观利器
芯片衬底刻蚀技术:精准控温的“微观利器
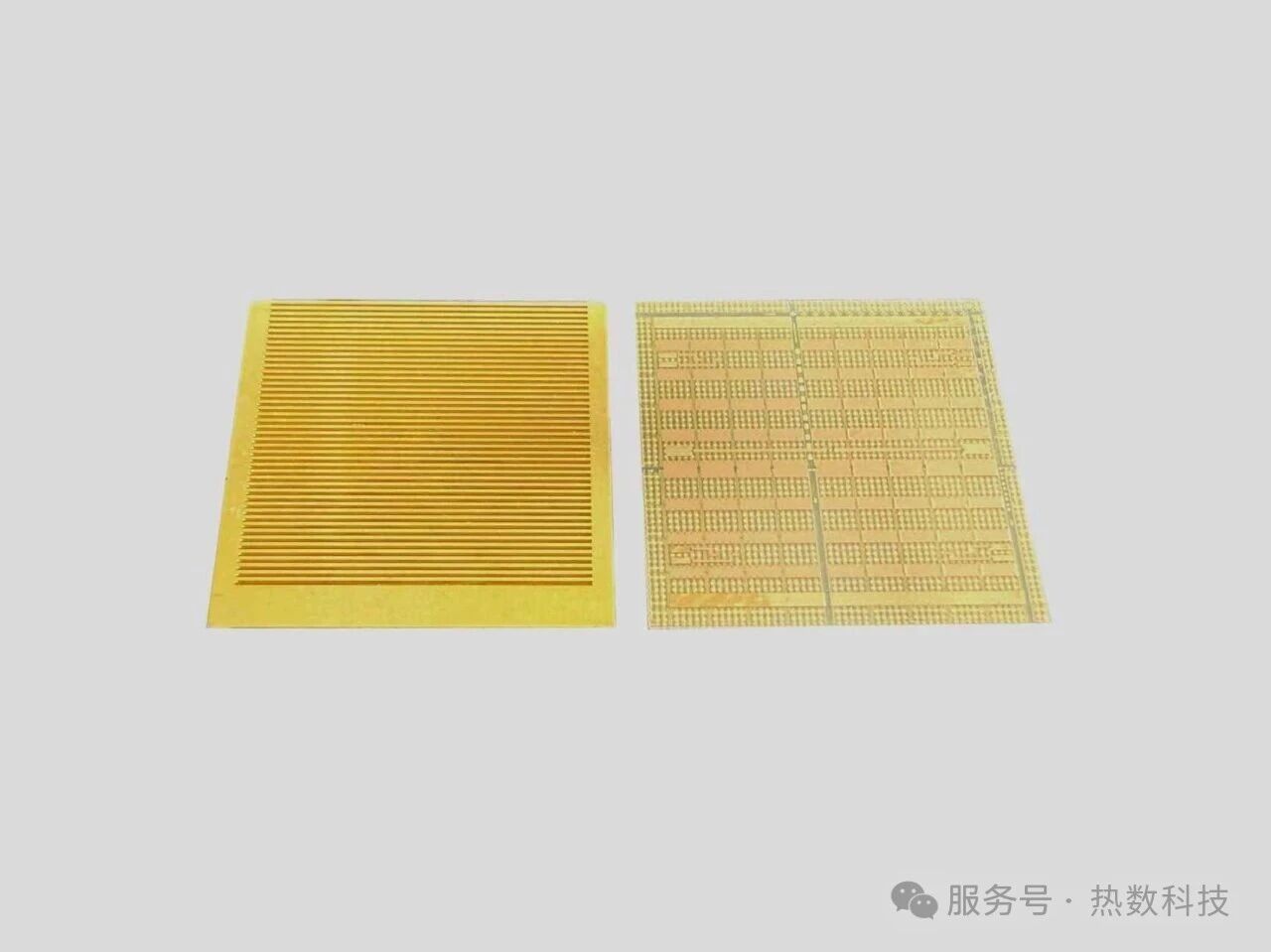
采用先进的激光微加工技术在硅芯片背面直接刻蚀出宽度仅为50-100μm的微通道网络。这些通道采用仿生分形结构设计,通过多层分支网络实现流体的均匀分布,显著提升热交换效率。冷却液直接流经芯片热源,热阻值可降低至0.05°C·cm²/W以下,较传统方案降低60%以上。针对高热流密度芯片的局部热点,可通过差异化流道设计实现“精准热管理”,为先进制程芯片提供定制化散热解决方案。
微通道盖板技术(MLCP):高效换热的“核心载体


创新性地将微通道与金属盖板集成设计,采用复合梯度封装新材料制成。微通道采用“高深宽比”架构,通道宽度80-150μm,深度500-800μm,配合优化的湍流发生器设计,使冷却液在低流速下即可实现湍流状态,换热系数可达80000-100000W/m²·K。盖板内部采用多级分流架构,温度梯度控制在2°C以内,确保芯片全域散热均匀性。
三重壁垒破局,铸就技术“护城河”
复合梯度封装的材料突破
电子封装领域长期受困于多材料热膨胀特性差异,温度波动时易产生剧烈应力集中,导致界面开裂或结构失效。热数科技通过材料体系创新与工艺优化,攻克“梯度复合材料”精密制备难题:依托粉末冶金、熔渗等先进工艺,在微观尺度实现不同热膨胀系数材料的成分连续过渡与结构精确调控,消除尖锐界面与微观缺陷,实现应力平缓耗散,为高功率芯片的小型化、高耐用性提供核心材料支撑。
跨学科耦合的协同破解
MLCP设计需同时满足电磁、热、结构、流体四大领域需求,且各领域存在恶性循环式干扰。例如,芯片高频信号产生的热量会改变材料电阻,电阻变化又影响电流分布,进一步加剧发热。热数科技凭借长期学研积累与行业Konw-how,构建了涵盖电磁损耗计算、热传导仿真、结构应力分析、流体动力学模拟的全维度耦合模型。通过上百轮耦合仿真与迭代优化,最终实现各领域性能的协同平衡。
微米级蚀刻的精度掌控
MLCP的核心在于50-150μm级微通道蚀刻,需在芯片盖板或封装层直接加工流道。这要求与半导体制程高度协同。热数科技凭借激光微加工技术与工艺优化,实现高精度流道加工,突破行业工艺瓶颈。
热数科技微通道业务的技术突破,既为2000W级以上高功耗AI芯片提供高效稳定的散热解决方案,更成为数据中心、高性能计算等领域技术升级的“加速器”:在AI服务器领域,其“小体积+高换热”优势支撑更高密度芯片集成,打破散热限制的硬件瓶颈;在数据中心场景,精准热管理能力降低散热能耗,助力实现“高效散热+节能降耗”目标,为算力基础设施绿色高密度建设赋能。
面向AI算力向更高密度、更低能耗迭代的浪潮,热数科技将以全链条技术能力为核心支撑,持续迭代产品、拓展场景,在液冷散热产业重构中助力算力基础设施升级,致力于成为驱动AI算力跃升的核心力量。


